
胶水话题博客

根据《按材料类型(胶粘剂、非胶粘剂)、设备(导热、对流、先进、混合)、服务(安装与校准、优化与售后)、终端应用——全球预测至2022年报告》,热管理市场预计将以7.91%的复合年增长率增长,到2022年总价值将达到142.4亿美元。
这一市场增长可能是由于对更小、更轻设备的需求增加,以及消费电子产品中对热管理需求的提升。 在电子设备的热循环过程中,球栅阵列(BGA)和芯片级封装(CSP)与印刷电路板(PCB)之间存在相对运动,导致焊点的机械疲劳和失效,这些焊点将芯片电气连接到电路板。底填材料(通常为环氧树脂组成)通过毛细作用将芯片连接到电路板,然后加热固化。底填材料为焊点提供机械加固,从而延长芯片的使用寿命。这种机械加固提高了CSP、晶圆级芯片级封装(WLCSP)和倒装芯片组件的抗跌落性能,并将热循环性能提高约7至10倍。
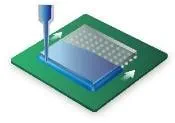
底填材料在便携设备中的使用正在增加,原因包括:
- 更精细的间距封装。
- POP封装。
- 更薄的主PCB。
- 更高要求的跌落测试。
- 更大的BGA/CSP和WLCSP。
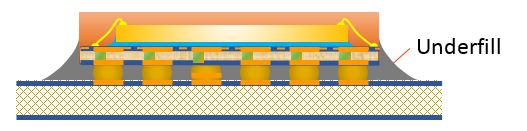
设备可靠性是电子行业中衡量产品性能的关键指标。高性能底填材料用于电子产品的芯片、设备或组件下方,以提高其可靠性,并为敏感设备组件提供结构加固。我们的PCB组装材料性能卓越,通过匹配材料来提供制造过程和设备性能的一致性,从而提高生产效率。
H.B. Fuller的底填材料通常提供:
- 高可靠性(抗跌落、抗冲击、高压灭菌和温度循环)。
- 快速流动和易于加工。
- 返工与可靠性之间的平衡。
- 出色的助焊剂兼容性。
阅读更多关于我们的PCB组装,以及我们如何与您合作,帮助解决您所有电子产品粘接和封装的需求。
博客分类
档案
- 2026
- 2025
- 2024
- 2023
- 2022

