
Le Blog Glue Talk

Selon le rapport Thermal Management Market by Material Type (Adhesive, Non-Adhesive), Devices (Conduction, Convection, Advanced, Hybrid), Service (Installation & Calibration, Optimization & Post Sales), End-Use Application - Global Forecast to 2022, le marché de la gestion thermique devrait croître à un taux de croissance annuel composé (CAGR) de 7,91 % pour atteindre une valeur totale de 14,24 milliards de dollars USD d'ici 2022.
Cette croissance du marché est probablement due à une demande accrue pour des appareils plus petits et plus légers ainsi qu'à un besoin croissant de gestion thermique dans l'électronique grand public. Dans le cycle thermique des appareils électroniques, il existe un mouvement relatif entre le Ball Grid Array (BGA), les Chip Scale Packages (CSPs) et les cartes de circuits imprimés (PCBs), entraînant une fatigue mécanique et une défaillance des joints de soudure qui interconnectent électriquement la puce à la carte. Un sous-remplissage, généralement une composition époxyde, relie la puce à la carte par action capillaire, puis est chauffé pour durcir. Le matériau de sous-remplissage fournit un renforcement mécanique aux joints de soudure, ce qui peut augmenter la durée de vie de la puce. Ce renforcement mécanique améliore la performance en cas de chute et augmente la performance du cycle thermique pour les CSP, les Wafer Level Chip Scale Packages (WLCSP) et les composants Flip Chip d'environ sept à dix fois.
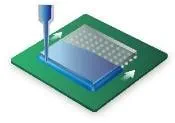
L'utilisation du sous-remplissage augmente dans les appareils portables en raison de :
- Paquets à pas fin.
- Paquets POP.
- Cartes principales PCBs plus fines.
- Exigences de test de chute difficiles.
- BGA/CSPs et WLCSPs plus grands.
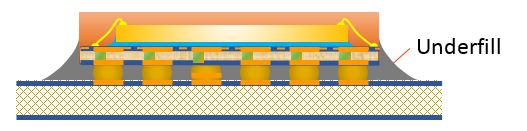
La fiabilité des appareils est une mesure essentielle de la performance des produits dans l'industrie électronique. Les matériaux de sous-remplissage haute performance sont utilisés sous les puces, appareils ou composants des produits électroniques pour améliorer leur fiabilité et offrir un renforcement structurel des composants sensibles des appareils. Nos matériaux d'assemblage PCB offrent d'excellentes performances et peuvent augmenter la productivité en associant des matériaux pour garantir une cohérence dans le processus de fabrication et la performance des appareils.
Les sous-remplissages H.B. Fuller offrent généralement :
- Haute fiabilité (chute, choc, autoclave et cycle thermique).
- Écoulement rapide et traitement facile.
- Équilibre entre la possibilité de retouche et la fiabilité.
- Excellente compatibilité avec le flux.
En savoir plus sur notre assemblage PCB et comment nous pouvons collaborer avec vous pour répondre à tous vos besoins en matière de collage et d'encapsulation électroniques.
Catégories de blog
Catégories de blog
Archive
-
2026
-
January (5)
- Élever les performances : Comment H.B. Fuller alimente l’avenir de la fabrication d’ascenseurs
- S’orienter dans la législation EPR aux États-Unis : comment les adhésifs et les emballages peuvent se conformer aux réglementations
- Alimenter l’avenir : La croissance des nouvelles solutions de stockage d’énergie
- Remettre les pendules à l’heure : Pourquoi les revêtements de toiture sont un système, et non une solution rapide
- Les partenariats stratégiques redéfinissent la distribution de toiture—Voici comment H.B. Fuller vous aide à garder une longueur d’avance
-
February (5)
- Au‑delà de l’adhérence : Les adhésifs comme moteurs d’innovation dans l’industrie des rubans adhésifs
- EternaBond® Dry Technology System : Adopter une approche automobile pour l'étanchéité des camping-cars
- Innovation Mondiale en Action
- Pourquoi le choix de l’adhésif est essentiel pour l’efficacité de l’emballage rigide
- Pourquoi la flexibilité est importante dans les adhésifs pour ongles
-
March (5)
- Adhésifs et recyclabilité : pourquoi ils sont importants
- Tendances de l'emballage flexible pour 2026 : de l'élan à la maturité
- Journée du recyclage : Comment l’innovation et la responsabilité transforment l’avenir des matériaux
- Pourquoi l’expertise RRO est essentielle pour offrir de meilleures solutions de toiture
- Conseils d’hiver pour l’utilisation des adhésifs de toiture
-
April (6)
- De la vapeur à la durabilité
- Comment le Minnesota fait progresser le prochain chapitre de la croissance mondiale de H.B. Fuller
- Comment les adhésifs en spray appliqués à partir de canisters aident les couvreurs à surmonter les pénuries mondiales de main-d'œuvre
- Les tendances des yachts de luxe rencontrent les technologies de collage avancées
- Plus qu’un scellant : Présentation de la technologie de liaison intelligente Lash Fuser
- Naviguer dans les tendances et défis de l'emballage : Advantra® Earthic™ 9500 comme solution révolutionnaire
- May (2)
-
January (5)
-
2025
-
January (4)
- Ne soyez pas surpris par la Loi de Modernisation de la Réglementation des Cosmétiques de 2022
- Renforcer le pouvoir le confort quotidien avec confiance
- Flexibilité tournée vers l'avenir : Les principales tendances de l'emballage flexible pour 2025
- Mentors et Résilience : Une Étoile de la Vente Partage ses Conseils
-
February (5)
- Choisir le bon adhésif : Chaussures
- Choisir le bon adhésif : applications textiles
- Rencontrez votre équipe : Brice Bardel, Directeur Commercial Mondial, Rubans, Étiquettes et Graphiques
- Naviguer dans les tendances de conception des batteries de véhicules électriques
- Adhésifs Thermofusibles Réactifs : Une Révolution dans la Technologie de Collage
-
March (5)
- Célébrer les femmes dans la science à l'occasion de la Journée internationale des femmes
- Choisir les bons adhésifs et mastics pour les applications automobiles
- Détachement à la demande dans les batteries de véhicules électriques : l'avenir du recyclage et de la réutilisation efficaces
- Production nationale et crédits d'impôt : L'impact de l'IRA sur la fabrication solaire
- Pourquoi nous disons adhésifs cosmétiques – La science derrière les formulations de beauté
- April (2)
-
May (7)
- Système de dilution automatique (ADS) pour des performances améliorées dans la fabrication de papier tissu et de serviettes
- Adhésifs de beauté en Europe
- Avantages de l’utilisation des adhésifs thermiquement conducteurs et des encapsulants dans les batteries Li-Ion
- Innovation par la collaboration : Les lauréats des Customer Innovation Awards de H.B. Fuller
- H.B. Fuller étend ses capacités de production dans la région IMEA
- Parlons de la chimie de la beauté – Comment simplifier et communiquer
- Les principales tendances de consommation façonnant le marché des produits de papier hygiénique et d'essuie-tout
-
June (4)
- Tendances mondiales des brasseries pour 2025 et avancées dans l'emballage
- Bonnes pratiques de fabrication pour l'industrie cosmétique
- À l'intérieur du processus de développement des adhésifs pour la beauté
- Intégration de solins : la solution de montage pour accélérer la vitesse d'installation solaire
-
July (9)
- Revêtements barrières pour les emballages alimentaires à base de papier : un guide sur la conformité et la performance
- Les colles pour cils fonctionnent-elles en faible humidité ?
- Choisir le bon adhésif : Hygiène
- H.B. Fuller fait progresser la toiture commerciale avec Millennium PG-1 EF ECO₂
- Comment les adhésifs avancés aident les entreprises à prospérer dans l'économie circulaire
- Comment les technologies adhésives innovantes et les pratiques de fabrication favorisent la durabilité
- Adhésifs pour étiquettes à un carrefour : répondre aux exigences d’un avenir durable et performant
- Collage intelligent une arme secrète pour améliorer l’assemblage industriel
- Collez Malin : Pourquoi un Retrait Propre et une Adhérence Facile Sont Essentiels pour la Décoration Murale DIY
-
August (3)
- Innover pour une installation rapide et fiable de panneaux solaires
- Maîtriser les adhésifs en canister appliqués par pulvérisation : Conseils, sécurité et meilleures pratiques
- Attention avant de faire ces déclarations : Une liste de contrôle de conformité pour les propriétaires de marques de beauté et les grossistes
- September (3)
-
October (6)
- Tendances mondiales 2025 dans l’industrie de l’hygiène jetable
- Lancement de Fuller Impact : Une nouvelle ère pour soutenir les communautés mondiales
- Adhésifs légers pour la fabrication de véhicules électriques : Réduction du poids, amélioration de l’autonomie
- Faites la différence 2025
- Le coût caché du butyle à bas prix
- Le rôle des adhésifs dans les solutions de stockage d'énergie renouvelable de nouvelle génération
-
November (6)
- Des panneaux solaires à l'eau recyclée : promouvoir la durabilité et l'impact commercial en Colombie
- Électrifier l’avenir : Tendances 2026 dans la fabrication d’autobus et le rôle de H.B. Fuller dans l’innovation durable
- Guide des adhésifs pour bois d'ingénierie
- Le marché des deux-roues et trois-roues en Inde : Accélération vers un avenir électrique
- Trois tendances émergentes dans l'industrie des polymères à base aqueuse
- Là où la science rencontre la peau : H.B. Fuller favorise l’apprentissage STEM au Musée des sciences du Minnesota
- December (2)
-
January (4)
-
2024
- January (1)
- March (1)
- April (1)
- May (2)
- June (2)
-
July (5)
- Tendances Émergentes dans la Couverture Commerciale et le Rôle Pivotal des Adhésifs
- Les adhésifs au service d'un emballage alimentaire respectueux de l'environnement
- Comment Construire la Marque de Beauté de Vos Rêves
- Terminologies du développement durable : Un voyage dans les mots qui définissent l'impact environnemental
- La Puissance des Adhésifs et Mastics en Silicone dans les Applications de Panneaux Solaires
- August (4)
- September (4)
- October (1)
-
November (4)
- Comment les adhésifs pour emballage flexible évoluent pour répondre aux défis actuels
- Comment choisir le bon adhésif pour les applications aérospatiales
- L'importance d'une gestion thermique complète dans les systèmes de batteries de véhicules électriques
- Tendances des Piles de 2025 : Qu'est-ce qui Alimente l'Avenir de l'Énergie?
- December (4)
- 2023
-
2022
- February (4)
- March (3)
- April (1)
- May (2)
- June (4)
-
August (6)
- Marché de l'étiquetage des boissons en Afrique : Principales tendances, opportunités et innovations
- Maison de la Colle H.B. Fuller : Chasse au Trésor
- Augmentation de la population mondiale vieillissante : impacts et défis
- Innovations et principaux défis dans les produits d'hygiène absorbants jetables durables
- Soutenir l'équité raciale dans notre communauté
- Les 5 principales raisons d'investir dans H.B. Fuller
- September (4)
- November (2)
- December (2)

