
El Blog de Glue Talk

Según el informe Thermal Management Market by Material Type (Adhesive, Non-Adhesive), Devices (Conduction, Convection, Advanced, Hybrid), Service (Installation & Calibration, Optimization & Post Sales), End-Use Application - Global Forecast to 2022, se espera que el mercado de gestión térmica crezca a una tasa compuesta anual (CAGR) del 7,91 por ciento, alcanzando un valor total de $14,24 mil millones USD para 2022.
Este crecimiento del mercado probablemente se deba a una mayor demanda de dispositivos más pequeños y ligeros, así como a una necesidad creciente de gestión térmica en la electrónica de consumo. En el ciclo térmico de los dispositivos electrónicos, hay un movimiento relativo entre el Ball Grid Array (BGA) y los Chip Scale Packages (CSPs) y las placas de circuito impreso (PCBs), lo que resulta en fatiga mecánica y fallos en las juntas de soldadura que interconectan eléctricamente el chip con la placa. Un underfill, típicamente una composición de epoxy, conecta el chip con la placa mediante acción capilar y luego se calienta para su curado. El material underfill proporciona refuerzo mecánico a las juntas de soldadura, lo que puede aumentar la vida útil del chip. Este refuerzo mecánico mejora el rendimiento frente a caídas y aumenta el rendimiento del ciclo térmico para los CSP, Wafer Level Chip Scale Packages (WLCSP) y componentes Flip Chip aproximadamente de siete a diez veces.
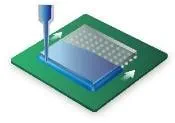
El uso de underfill está aumentando en los dispositivos portátiles debido a:
- Paquetes de paso más fino.
- Paquetes POP.
- Placas principales más delgadas.
- Requisitos desafiantes de pruebas de caída.
- BGA/CSPs y WLCSPs más grandes.
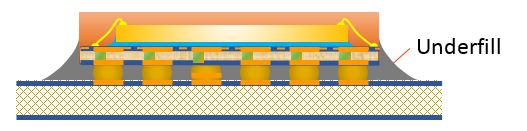
La confiabilidad del dispositivo es una medida crítica del rendimiento del producto en la industria electrónica. Los materiales de underfill de alto rendimiento se utilizan debajo de los chips, dispositivos o componentes de productos electrónicos para mejorar su confiabilidad y ofrecer refuerzo estructural a los componentes sensibles del dispositivo. Nuestros materiales para ensamblaje de PCBs tienen un excelente rendimiento y pueden aumentar la productividad al combinar materiales que proporcionan consistencia en el proceso de fabricación y el rendimiento del dispositivo.
Los underfills de H.B. Fuller típicamente ofrecen:
- Alta confiabilidad (caídas, golpes, autoclave y ciclo de temperatura).
- Flujo rápido y fácil procesamiento.
- Equilibrio entre capacidad de reprocesamiento y confiabilidad.
- Excelente compatibilidad con flux.
Lea más sobre nuestro ensamblaje de PCBs y cómo podemos asociarnos con usted para ayudarle a resolver todas sus necesidades de unión y encapsulación de componentes electrónicos.
Categorías del Blog
Categorías del Blog
Archivo
-
2026
-
January (5)
- Elevando el rendimiento: Cómo H.B. Fuller impulsa el futuro de la fabricación de ascensores
- Navegando la legislación EPR en Estados Unidos: Cómo los adhesivos y los envases pueden cumplir con la normativa
- Impulsando el futuro: El crecimiento del nuevo almacenamiento de energía
- Aclarando las cosas: Por qué los recubrimientos para techos son un sistema, no un atajo
- Las alianzas estratégicas están transformando la distribución de techos—Así es como H.B. Fuller te ayuda a mantenerte a la vanguardia
-
February (5)
- Más allá de la adhesión: Los adhesivos como impulsores de la innovación en la industria de cintas
- EternaBond® Dry Technology System: Un enfoque automotriz para el sellado de vehículos recreativos
- Innovación Global en Acción
- Por qué la selección de adhesivos es importante para la eficiencia del embalaje rígido
- Por qué la flexibilidad importa en los adhesivos para uñas
-
March (5)
- Adhesivos y reciclabilidad: Por qué son importantes
- Tendencias del empaque flexible para 2026: del impulso a la madurez
- Día del Reciclaje: Cómo la innovación y la responsabilidad están transformando el futuro de los materiales
- Por qué la experiencia RRO es importante para ofrecer mejores soluciones de techado
- Consejos de invierno para usar adhesivos para techos
-
April (6)
- Del vapor a la sostenibilidad
- Cómo Minnesota está impulsando el próximo capítulo de crecimiento global de H.B. Fuller
- Cómo los adhesivos en aerosol aplicados desde canister ayudan a los contratistas de techos a superar la escasez global de mano de obra
- Tendencias de yates de lujo se encuentran con tecnologías avanzadas de unión
- Más que un sellador: Presentamos la tecnología de unión inteligente Lash Fuser
- Navegando por las Tendencias y Desafíos del Embalaje: Advantra® Earthic™ 9500 como la Solución Revolucionaria
- May (4)
-
January (5)
-
2025
- January (4)
-
February (5)
- Eligiendo el Adhesivo Adecuado: Calzado
- Eligiendo el Adhesivo Adecuado: Aplicaciones Textiles
- Conoce a tu equipo: Brice Bardel, Director Global de Negocios, Cintas, Etiquetas y Gráficos
- Navegando las Tendencias en el Diseño de Baterías para Vehículos Eléctricos
- Adhesivos Termofusibles Reactivos: Una Revolución en la Tecnología de Unión
-
March (5)
- Celebrando a las Mujeres en la Ciencia en el Día Internacional de la Mujer
- Elegir los Adhesivos y Selladores Correctos para Aplicaciones Automotrices
- Despegado a Demanda en Baterías de Vehículos Eléctricos: El Futuro del Reciclaje y Reutilización Eficiente
- Producción Nacional y Créditos Fiscales: El Impacto de la IRA en la Fabricación Solar
- Por qué decimos adhesivos cosméticos: la ciencia detrás de las formulaciones de belleza
- April (2)
-
May (7)
- Auto Dilution System (ADS) para un Rendimiento Mejorado en la Fabricación de Papel Higiénico y Toallas
- Adhesivos de Belleza en Europa
- Beneficios de usar adhesivos y encapsulantes térmicamente conductivos en baterías de iones de litio
- Innovación a través de la colaboración: Ganadores de los Premios a la Innovación del Cliente de H.B. Fuller
- H.B. Fuller amplía sus capacidades de fabricación en la región IMEA
- Hablando de Química de la Belleza: Cómo Simplificar y Comunicar
- Principales Tendencias de los Consumidores que Están Moldeando el Mercado de Productos de Papel Higiénico y Toallas
- June (4)
-
July (9)
- Recubrimientos de Barrera para Envases de Alimentos a Base de Papel: Una Guía sobre Cumplimiento y Rendimiento
- ¿Pueden los adhesivos para pestañas funcionar en condiciones de baja humedad?
- Elegir el adhesivo adecuado: Higiene
- H.B. Fuller impulsa la construcción de techos comerciales con Millennium PG-1 EF ECO₂
- Cómo los adhesivos avanzados ayudan a las empresas a prosperar en la economía circular
- Cómo la tecnología innovadora de adhesivos y las prácticas de fabricación impulsan la sustentabilidad
- Adhesivos para etiquetas en una encrucijada: Cumpliendo con las demandas de un futuro sostenible y de alto rendimiento
- Un Enlace Más Inteligente como un Arma Secreta para Mejorar el Ensamblaje Industrial
- Pega con Inteligencia: Por Qué la Remoción Limpia y la Adhesión Fácil Son Importantes en la Decoración de Pared DIY
-
August (3)
- Innovando hacia una instalación rápida y confiable de paneles solares
- Dominando los adhesivos en aerosol de envase presurizado: Consejos, seguridad y mejores prácticas
- Cuidado antes de hacer estas afirmaciones: una lista de verificación de cumplimiento para propietarios y mayoristas de marcas de belleza
- September (3)
-
October (6)
- Tendencias Globales 2025 en la Industria de Higiene Desechable
- Lanzamiento de Fuller Impact: Una nueva era en el apoyo a las comunidades globales
- Adhesivos ligeros para la fabricación de vehículos eléctricos: Reduciendo peso, mejorando autonomía
- Marca la diferencia 2025
- El costo oculto del butilo de bajo precio
- El papel de los adhesivos en las soluciones de almacenamiento de energía renovable de próxima generación
-
November (6)
- De paneles solares a agua reciclada: Impulsando la sustentabilidad y el impacto empresarial en Colombia
- Electrificando el futuro: Tendencias 2026 en la fabricación de autobuses y el papel de H.B. Fuller en la innovación sostenible
- Guía de adhesivos para madera de ingeniería
- El mercado de vehículos de dos y tres ruedas en India: acelerando hacia un futuro eléctrico
- Tres tendencias emergentes en la industria de polímeros a base de agua
- Donde la ciencia se encuentra con la piel: H.B. Fuller impulsa el aprendizaje STEM en el Museo de Ciencias de Minnesota
- December (2)
-
2024
- January (1)
- March (1)
- April (1)
- May (2)
- June (2)
-
July (5)
- Tendencias Emergentes en Techado Comercial y el Papel Pivotal de los Adhesivos
- Cómo Los adhesivos avanzan en el embalaje de alimentos ecológico
- Cómo Construir la Marca de Belleza de tus Sueños
- Términos de Sustentabilidad: Un Viaje a las Palabras que Definen el Impacto Ambiental
- La potencia de los adhesivos siliconados y selladores en aplicaciones de paneles solares
- August (4)
- September (4)
- October (1)
-
November (4)
- Cómo están evolucionando los adhesivos para embalaje flexible para enfrentar los desafíos actuales
- Cómo elegir el adhesivo adecuado para aplicaciones aeroespaciales
- La importancia de la gestión térmica integral en los sistemas de baterías de vehículos eléctricos
- Tendencias de Baterías de 2025: ¿Qué Está Impulsando el Futuro de la Energía?
- December (4)
- 2023
-
2022
- February (4)
- March (3)
- April (1)
- May (2)
- June (4)
-
August (6)
- Mercado de Etiquetado de Bebidas en África: Tendencias Clave, Oportunidades e Innovaciones
- La Casa de Pegamento de H.B. Fuller: Búsqueda del Tesoro
- Envejecimiento Global de la Población: Impactos y Desafíos
- Innovaciones y Desafíos Clave en los Productos Higiénicos Absorbentes Desechables Sostenibles
- Apoyando la Equidad Racial en Nuestra Comunidad
- Las 5 Principales Razones para Invertir en H.B. Fuller
- September (4)
- November (2)
- December (2)

