
O Blog Glue Talk

De acordo com o relatório Thermal Management Market by Material Type (Adhesive, Non-Adhesive), Devices (Conduction, Convection, Advanced, Hybrid), Service (Installation & Calibration, Optimization & Post Sales), End-Use Application - Global Forecast to 2022, o mercado de gerenciamento térmico deve crescer a uma taxa composta de crescimento anual (CAGR) de 7,91%, com um valor total de $14,24 bilhões de dólares até 2022.
Esse crescimento de mercado provavelmente se deve à maior demanda por dispositivos menores e mais leves e à necessidade crescente de gerenciamento térmico em eletrônicos de consumo. Durante o ciclo térmico de dispositivos eletrônicos, há movimento relativo entre o Ball Grid Array (BGA) e os Chip Scale Packages (CSPs) e as placas de circuito impresso (PCBs), resultando em fadiga mecânica e falha nas juntas de solda que interconectam eletricamente o chip à placa. Um underfill, tipicamente uma composição de epóxi, conecta o chip à placa por ação capilar e, em seguida, é aquecido para cura. O material de underfill fornece reforço mecânico às juntas de solda, o que pode aumentar a vida útil do chip. Esse reforço mecânico melhora o desempenho em quedas e aumenta o desempenho do ciclo térmico para CSP, Wafer Level Chip Scale Packages (WLCSP) e componentes Flip Chip em cerca de sete a 10 vezes.
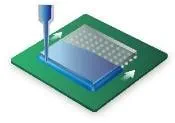
O uso de underfill está aumentando em dispositivos portáteis devido a:
- Pacotes com pitch mais fino.
- Pacotes POP.
- Placas principais (PCBs) mais finas.
- Requisitos desafiadores de teste de queda.
- BGA/CSPs e WLCSPs maiores.
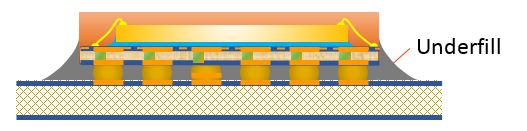
A confiabilidade dos dispositivos é uma medida crítica de desempenho de produtos na indústria eletrônica. Materiais de underfill de alto desempenho são usados sob chips, dispositivos ou componentes de produtos eletrônicos para melhorar sua confiabilidade e oferecer reforço estrutural a componentes sensíveis dos dispositivos. Nossos materiais para montagem de PCBs possuem excelente desempenho e podem aumentar a produtividade ao combinar materiais para proporcionar consistência no processo de fabricação e no desempenho dos dispositivos.
Os underfills da H.B. Fuller geralmente oferecem:
- Alta confiabilidade (queda, choque, autoclave e ciclo de temperatura).
- Fluxo rápido e fácil processamento.
- Equilíbrio entre retrabalho e confiabilidade.
- Excelente compatibilidade com fluxos.
Leia mais sobre nossa montagem de PCBs e como podemos colaborar com você para ajudar a resolver todas as suas necessidades de colagem e encapsulamento de eletrônicos.
Categorias do Blog
Categorias do Blog
Arquivo
-
2026
-
January (5)
- Elevando o desempenho: Como a H.B. Fuller impulsiona o futuro da fabricação de elevadores
- Navegando pela Legislação EPR nos EUA: Como Adesivos e Embalagens Podem Atender às Regulamentações
- Impulsionando o futuro: O crescimento do novo armazenamento de energia
- Esclarecendo os Fatos: Por Que os Revestimentos de Telhados São um Sistema, Não um Atalho
- Parcerias Estratégicas estão Remodelando a Distribuição de Telhados—Veja Como a H.B. Fuller Ajuda Você a Permanecer à Frente
-
February (5)
- Além da Adesão: Adesivos como impulsionadores de inovação na indústria de fitas
- EternaBond® Dry Technology System: Uma abordagem automotiva para a vedação de veículos recreativos (RVs)
- Inovação Global em Ação
- Por que a Seleção de Adesivos é Importante para a Eficiência de Embalagens Rígidas
- Por que a Flexibilidade Importa em Adesivos para Unhas
-
March (5)
- Adesivos e reciclabilidade: por que são importantes
- Tendências em Embalagens Flexíveis para 2026: Do Impulso à Maturidade
- Dia da Reciclagem: Como a Inovação e a Responsabilidade Estão Transformando o Futuro dos Materiais
- Por que a Expertise RRO é Importante para Oferecer Melhores Soluções de Cobertura
- Dicas de inverno para usar adesivos de telhado
-
April (6)
- Do vapor à sustentabilidade
- Como Minnesota está impulsionando o próximo capítulo de crescimento global da H.B. Fuller
- Como os adesivos de pulverização aplicados por canister ajudam os empreiteiros de telhados a superar a escassez global de mão de obra
- Tendências de Iates de Luxo Encontrem Tecnologias Avançadas de Colagem
- Mais do que um Selante: Apresentando a Tecnologia Inteligente de Colagem Lash Fuser
- Navegando pelas Tendências e Desafios de Embalagem: Advantra® Earthic™ 9500 como a Solução Transformadora
- May (4)
-
January (5)
-
2025
- January (4)
-
February (5)
- Escolhendo o Adesivo Certo: Calçados
- Escolhendo o Adesivo Certo: Aplicações Têxteis
- Conheça Sua Equipe: Brice Bardel, Diretor Global de Negócios, Fitas, Etiquetas e Gráficos
- Navegando nas Tendências de Design de Baterias para Veículos Elétricos
- Adesivos Termofusíveis Reativos: Uma Revolução na Tecnologia de Colagem
-
March (5)
- Celebrando as Mulheres na Ciência no Dia Internacional da Mulher
- Escolhendo os Adesivos e Selantes Certos para Aplicações Automotivas
- Descolagem sob Demanda em Baterias de Veículos Elétricos: O Futuro da Reciclagem e Reutilização Eficientes
- Produção Doméstica & Créditos Fiscais: O Impacto da IRA na Fabricação Solar
- Por que Dizemos Adesivos Cosméticos – A Ciência por Trás das Formulações de Beleza
- April (2)
-
May (7)
- Auto Dilution System (ADS) para Desempenho Aprimorado na Fabricação de Papel Tissue e Toalhas
- Adesivos de Beleza na Europa
- Benefícios do Uso de Adesivos e Encapsulantes Termicamente Condutivos em Baterias de Íons de Lítio
- Inovação Através da Colaboração: Vencedores do Prêmio de Inovação para Clientes da H.B. Fuller
- H.B. Fuller Expande Capacidades de Manufatura na Região IMEA
- Falando sobre Química da Beleza – Como Simplificar e Comunicar
- Principais Tendências de Consumo que Estão Moldando o Mercado de Produtos de Papel Tissue e Toalhas
- June (4)
-
July (9)
- Barreiras de Revestimento para Embalagens de Alimentos à Base de Papel: Um Guia para Conformidade e Desempenho
- Adesivos para cílios funcionam em baixa umidade?
- Escolhendo o adesivo certo: Higiene
- H.B. Fuller impulsiona a cobertura comercial com o Millennium PG-1 EF ECO₂
- Como Adesivos Avançados Ajudam Empresas a Prosperar na Economia Circular
- Como a Tecnologia Inovadora de Adesivos e as Práticas de Fabricação Impulsionam a Sustentabilidade
- Adesivos para Rótulos em um Ponto de Virada: Atendendo às Demandas de um Futuro Sustentável e de Alto Desempenho
- Smarter Bonding como uma Arma Secreta para Melhorar a Montagem Industrial
- Cole com Inteligência: Por que a Remoção Limpa e a Fácil Adesão São Importantes na Decoração de Parede DIY
- August (3)
- September (3)
-
October (6)
- Tendências Globais de 2025 na Indústria de Higiene Descartável
- Lançando Fuller Impact: Uma Nova Era de Apoio às Comunidades Globais
- Adesivos Leves para Fabricação de EV: Reduzindo Peso, Melhorando Alcance
- Faça a diferença 2025
- O custo oculto do butil de baixo custo
- O Papel dos Adesivos nas Soluções de Armazenamento de Energia Renovável de Próxima Geração
-
November (6)
- De painéis solares a água reciclada: impulsionando a sustentabilidade e o impacto nos negócios na Colômbia
- Eletrificando o futuro: Tendências de 2026 na fabricação de ônibus e o papel da H.B. Fuller na inovação sustentável
- Guia de Adesivos para Madeira Engenheirada
- Mercado de Veículos de Duas e Três Rodas na Índia: Acelerando Rumo a um Futuro Elétrico
- Três Tendências Emergentes na Indústria de Polímeros com Base de Água
- Onde a ciência encontra a pele: H.B. Fuller impulsiona o aprendizado STEM no Museu de Ciências de Minnesota
- December (2)
-
2024
- January (1)
- March (1)
- April (1)
- May (2)
- June (2)
-
July (5)
- Tendências Emergentes em Telhados Comerciais e o Papel Fundamental dos Adesivos
- Como Adesivos Avançam a Embalagem de Alimentos Sustentável
- Como Construir a Marca de Beleza dos Seus Sonhos
- Termos de Sustentabilidade: Uma Jornada Pelas Palavras que Definem o Impacto Ambiental
- O Poder dos Adesivos e Selantes de Silicone em Aplicações de Painéis Solares
- August (4)
- September (4)
- October (1)
-
November (4)
- Como os Adesivos para Embalagem Flexível Estão Evoluindo para Enfrentar os Desafios de Hoje
- Como Escolher o Adesivo Certo para Aplicações Aeroespaciais
- A Importância da Gestão Térmica Abrangente em Sistemas de Bateria de Veículos Elétricos
- Perspectivas para Baterias em 2025: O que Está Energizando o Futuro da Energia?
- December (4)
- 2023
-
2022
- February (4)
- March (3)
- April (1)
- May (2)
- June (4)
-
August (6)
- Mercado de Rotulagem de Bebidas na África: Principais Tendências, Oportunidades e Inovações
- Pote de Cola da H.B. Fuller: Caça ao Tesouro
- Aumento da População Idosa Global: Impactos e Desafios
- Inovações e Principais Desafios em Produtos Absorventes Descartáveis Sustentáveis para Higiene
- Apoiar a Equidade Racial em Nossa Comunidade
- Top 5 Razões para Investir na H.B. Fuller
- September (4)
- November (2)
- December (2)

