
Der Leim Talk Blog

Laut dem Thermal Management Market by Material Type (Adhesive, Non-Adhesive), Devices (Conduction, Convection, Advanced, Hybrid), Service (Installation & Calibration, Optimization & Post Sales), End-Use Application - Global Forecast to 2022 report wird erwartet, dass der Markt für Wärmemanagement bis 2022 mit einer CAGR von 7,91 Prozent wächst und einen Gesamtwert von 14,24 Milliarden USD erreicht.
Dieses Marktwachstum ist wahrscheinlich auf eine höhere Nachfrage nach kleineren und leichteren Geräten sowie auf einen erhöhten Bedarf an Wärmemanagement in der Unterhaltungselektronik zurückzuführen. Im thermischen Zyklus von elektronischen Geräten gibt es eine relative Bewegung zwischen dem Ball Grid Array (BGA) und den Chip Scale Packages (CSPs) sowie den Leiterplatten (PCBs), was zu mechanischer Ermüdung und zum Versagen der Lötstellen führt, die den Chip elektrisch mit der Platine verbinden. Ein Unterfüllmaterial, typischerweise eine Epoxidzusammensetzung, verbindet den Chip durch Kapillarwirkung mit der Platine und wird anschließend erhitzt, um auszuhärten. Das Unterfüllmaterial bietet mechanische Verstärkung für die Lötstellen, was die Lebensdauer des Chips erhöhen kann. Diese mechanische Verstärkung verbessert die Fallleistung und erhöht die thermische Zyklusleistung für CSP, Wafer Level Chip Scale Packages (WLCSP) und Flip-Chip-Komponenten um etwa das Sieben- bis Zehnfache.
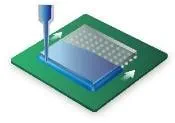
Die Verwendung von Unterfüllmaterialien nimmt bei tragbaren Geräten aufgrund folgender Faktoren zu:
- Feinere Pitch-Packages.
- POP-Packages.
- Dünnere Hauptplatinen (PCBs).
- Herausfordernde Falltestanforderungen.
- Größere BGA/CSPs und WLCSPs.
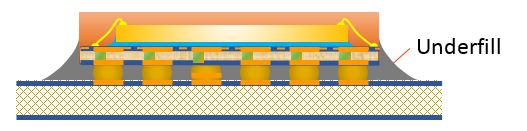
Die Zuverlässigkeit von Geräten ist ein entscheidendes Maß für die Produktleistung in der Elektronikindustrie. Hochleistungsfähige Unterfüllmaterialien werden unter Chips, Geräten oder Komponenten von elektronischen Produkten verwendet, um deren Zuverlässigkeit zu verbessern und empfindliche Gerätekomponenten strukturell zu verstärken. Unsere PCB-Materialien für die Montage bieten hervorragende Leistung und können die Produktivität steigern, indem sie Materialien anpassen, um Konsistenz im Herstellungsprozess und in der Geräteleistung zu gewährleisten.
H.B. Fuller Unterfüllmaterialien bieten typischerweise:
- Hohe Zuverlässigkeit (Fall-, Stoß-, Autoklav- und Temperaturzyklen).
- Schnellen Fluss und einfache Verarbeitung.
- Balance zwischen Wiederaufarbeitung und Zuverlässigkeit.
- Hervorragende Flussmittelkompatibilität.
Lesen Sie mehr über unsere PCB-Montage und wie wir mit Ihnen zusammenarbeiten können, um alle Ihre Anforderungen an Elektronikverklebung und Verkapselung zu lösen.
Blog-Kategorien
Blog-Kategorien
Archiv
-
2026
-
January (5)
- Leistungssteigerung: Wie H.B. Fuller die Zukunft der Aufzugsherstellung vorantreibt
- Navigation durch die EPR-Gesetzgebung in den USA: Wie Klebstoffe und Verpackungen die gesetzlichen Anforderungen erfüllen können
- Die Zukunft antreiben: Das Wachstum neuer Energiespeichertechnologien
- Klarstellung: Warum Dachbeschichtungen ein System sind und keine Abkürzung
- Strategische Partnerschaften verändern die Verteilung von Dachmaterialien – So hilft H.B. Fuller Ihnen, einen Schritt voraus zu bleiben
-
February (5)
- Über das Kleben hinaus: Klebstoffe als Wegbereiter für Innovationen in der Klebebandindustrie
- EternaBond® Dry Technology System: Ein automobiltechnischer Ansatz für die Abdichtung von Wohnmobilen
- Globale Innovation in Aktion
- Warum die Auswahl des Klebstoffs für die Effizienz bei starren Verpackungen wichtig ist
- Warum Flexibilität bei Nagelklebstoffen wichtig ist
-
March (5)
- Klebstoffe und Recyclingfähigkeit: Warum sie wichtig sind
- Flexible Packaging Trends für 2026: Von Dynamik zu Reife
- Recyclingtag: Wie Innovation und Verantwortung die Zukunft von Materialien verändern
- Warum RRO-Expertise bei der Bereitstellung besserer Dachlösungen wichtig ist
- Winter-Tipps für die Verwendung von Dachklebstoffen
-
April (6)
- Von Dampf zu Nachhaltigkeit
- Wie Minnesota das nächste Kapitel des globalen Wachstums von H.B. Fuller vorantreibt
- Wie sprühbare Kanisterklebstoffe Dachdecker dabei unterstützen, globale Arbeitskräftemängel zu überwinden
- Luxusyacht-Trends treffen auf fortschrittliche Klebetechnologien
- Mehr als ein Versiegler: Einführung der Lash Fuser Smart Bonding Technology
- Navigieren durch Verpackungstrends und -herausforderungen: Advantra® Earthic™ 9500 als bahnbrechende Lösung
- May (4)
-
January (5)
-
2025
- January (4)
-
February (5)
- Die Wahl des richtigen Klebstoffs: Schuhe
- Die Wahl des richtigen Klebstoffs: Textilanwendungen
- Lernen Sie Ihr Team kennen: Brice Bardel, Global Business Director, Tapes, Labels & Graphics
- Navigieren von Trends im Design von Batterien für Elektrofahrzeuge
- Reaktive Schmelzklebstoffe: Ein Game-Changer in der Klebetechnologie
-
March (5)
- Feier der Frauen in der Wissenschaft am Internationalen Frauentag
- Die richtige Wahl der Klebstoffe und Dichtstoffe für Automobilanwendungen
- Entklebung auf Anfrage in Batterien von Elektrofahrzeugen: Die Zukunft des effizienten Recyclings und der Wiederverwendung
- Inländische Produktion & Steueranreize: Die Auswirkungen des IRA auf die Solarproduktion
- Warum wir von kosmetischen Klebstoffen sprechen – Die Wissenschaft hinter Schönheitsformulierungen
- April (2)
-
May (7)
- Auto Dilution System (ADS) für verbesserte Leistung in der Tissue- und Handtuchherstellung
- Schönheitsklebstoffe in Europa
- Vorteile der Verwendung von thermisch leitfähigen Klebstoffen und Vergussmassen in Li-Ionen-Batterien
- Innovation durch Zusammenarbeit: H.B. Fuller’s Customer Innovation Awards Gewinner
- H.B. Fuller erweitert seine Produktionskapazitäten in der IMEA-Region
- Schönheitschemie verstehen – Wie man sie vereinfacht und vermittelt
- Top-Verbrauchertrends, die den Markt für Tissue- und Handtuchprodukte prägen
- June (4)
-
July (9)
- Barrierbeschichtungen für papierbasierte Lebensmittelverpackungen: Ein Leitfaden zu Konformität und Leistung
- Können Wimpernklebstoffe bei niedriger Luftfeuchtigkeit funktionieren
- Die Wahl des richtigen Klebstoffs: Hygiene
- H.B. Fuller treibt den gewerblichen Dachbau mit Millennium PG-1 EF ECO₂ voran
- Wie fortschrittliche Klebstoffe Unternehmen helfen, in der Kreislaufwirtschaft erfolgreich zu sein
- Wie innovative Klebstofftechnologie und Fertigungspraktiken Nachhaltigkeit fördern
- Labelklebstoffe an einem Wendepunkt: Den Anforderungen einer nachhaltigen und leistungsstarken Zukunft gerecht werden
- Smarter Bonding als Geheimwaffe zur Verbesserung der industriellen Montage
- Stick Smart: Warum sauberes Entfernen und einfache Haftung bei DIY-Wanddekorationen wichtig sind
-
August (3)
- Innovationen für eine schnelle und zuverlässige Installation von Solarmodulen
- Meisterung von sprühaufgetragenen Kanisterklebstoffen: Tipps, Sicherheit & bewährte Praktiken
- Achten Sie darauf, bevor Sie diese Behauptungen aufstellen: Eine Compliance-Checkliste für Markeninhaber und Großhändler in der Beauty-Branche
- September (3)
-
October (6)
- 2025 Globale Trends in der Einweg-Hygieneindustrie
- Einführung von Fuller Impact: Eine neue Ära der Unterstützung globaler Gemeinschaften
- Leichtbau-Klebstoffe für die EV-Fertigung: Gewicht reduzieren, Reichweite verbessern
- Mach einen Unterschied 2025
- Die versteckten Kosten von preisgünstigem Butyl
- Die Rolle von Klebstoffen in der nächsten Generation von Lösungen zur Speicherung erneuerbarer Energien
-
November (6)
- Von Solarmodulen bis zu recyceltem Wasser: Nachhaltigkeit und Geschäftsauswirkungen in Kolumbien vorantreiben
- Elektrifizierung der Zukunft: Trends 2026 in der Busproduktion und H.B. Fullers Rolle bei nachhaltiger Innovation
- Leitfaden für Klebstoffe für Holzwerkstoffe
- Indiens Markt für Zwei- und Dreiräder: Beschleunigung in Richtung einer elektrischen Zukunft
- Drei aufkommende Trends in der wasserbasierten Polymerindustrie
- Wo Wissenschaft auf Haut trifft: H.B. Fuller treibt MINT-Lernen im Science Museum of Minnesota voran
- December (2)
-
2024
- January (1)
- March (1)
- April (1)
- May (2)
- June (2)
-
July (5)
- Neue Trends bei kommerziellen Bedachungen und die zentrale Rolle von Klebstoffen
- Wie Klebstoffe umweltfreundliche Lebensmittelverpackungen vorantreiben
- Wie Sie die Schönheitsmarke Ihrer Träume aufbauen
- Terminologien der Nachhaltigkeit: Eine Reise zu den Begriffen, die die Umweltauswirkungen definieren
- Die Leistungsfähigkeit von Silikonklebstoffen und -dichtstoffen in Solarzellenanwendungen
- August (4)
- September (4)
- October (1)
-
November (4)
- Wie sich flexible Verpackungsklebstoffe entwickeln, um den heutigen Herausforderungen gerecht zu werden
- Wie man das richtige Klebstoff für Luft- und Raumfahrtanwendungen auswählt
- Die Bedeutung eines umfassenden thermischen Managements in Batteriesystemen von Elektrofahrzeugen
- Batterietrends 2025: Was die Zukunft der Energie antreibt?
- December (4)
- 2023
-
2022
- February (4)
- March (3)
- April (1)
- May (2)
- June (4)
-
August (6)
- Getränkeetikettierungsmarkt in Afrika: Wichtige Trends, Chancen und Innovationen
- H.B. Fullers Leimhaus: Schnitzeljagd
- Zunehmende Überalterung der Weltbevölkerung: Auswirkungen und Herausforderungen
- Innovationen und zentrale Herausforderungen bei nachhaltigen absorbierenden Einweg-Hygieneprodukten
- Unterstützung der Rassengleichheit in unserer Gemeinschaft
- Die 5 besten Gründe für eine Investition in H.B. Fuller
- September (4)
- November (2)
- December (2)

